晶圓是用來制造IC芯片的基礎(chǔ)材料,由晶體和硅熔體通過熔晶工藝制造出晶圓棒,再通過切片方式制造出單片晶圓,晶圓劃片則是劃線出單個晶體單位。
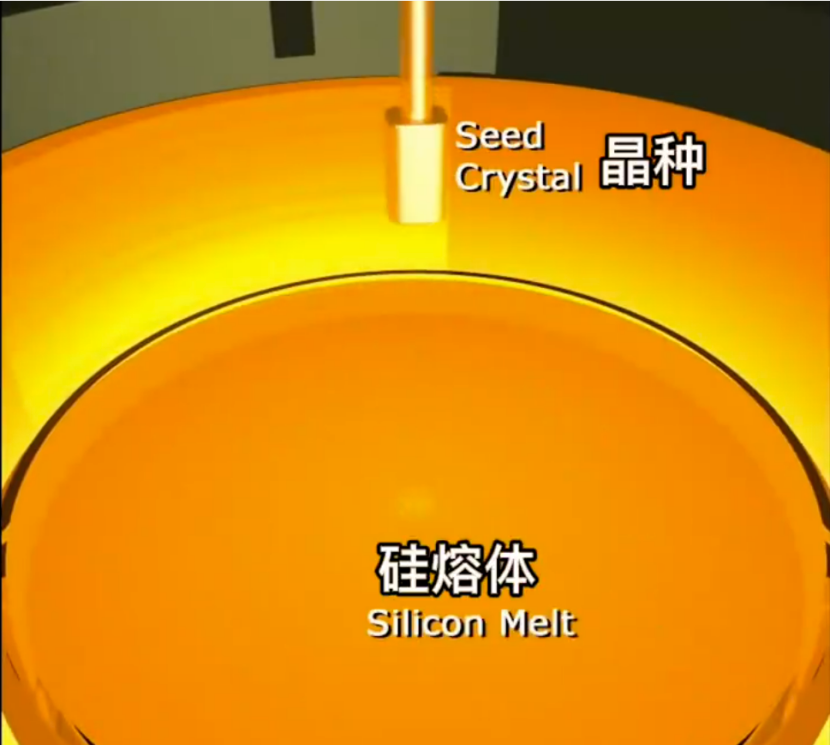

晶圓劃片工藝已經(jīng)不再只是把一個硅晶圓劃片成單獨的芯片這樣簡單的操作。隨著更多的封裝工藝在晶圓級完成,并且要進行必要的微型化,針對不同任務的要求,在分割工藝中需要對
不同的操作參數(shù)進行調(diào)整。例如,分割QFN封裝需要具有可以切割柔性和脆性材料組成的復合基板的能力。MEMS封裝則常常具有微小和精細的結(jié)構(gòu);梁、橋、鉸鏈、轉(zhuǎn)軸、膜和其他敏感形態(tài);這些都需要特別的操作技術(shù)和注意事項。在切割硅晶圓低厚度,或者像GaAs這樣的脆性材料時,又增添了額外的挑戰(zhàn)例如碎片、斷裂和殘渣的產(chǎn)生。

劃片方法主要有刀具劃片、激光劃片。
刀具劃片:是以強力磨削為手段,通過空氣靜壓支撐的電主軸帶動超薄金剛石刀片以高速旋轉(zhuǎn),用刀片上的微細磨粒與被加工物進行接觸,使劃切處的材料產(chǎn)生碎裂。

劣勢:
刀片劃片直接作用于晶圓表面,在晶體內(nèi)部產(chǎn)生損傷,容易產(chǎn)生晶圓崩邊及晶片破損;
刀片具有所的厚度,導致刀具的劃片線寬較大;
耗材大,刀片需每半個月更換一次;
環(huán)境污染大,切割后的硅粉水難處理。
激光劃片:利用高能激光束聚焦產(chǎn)生的高溫使照射局部范圍內(nèi)的硅材料瞬間氣化,完成硅片分離。
優(yōu)勢:
對芯片的電性影響小,可提高的劃片成品率;
可以對不同厚度的晶圓進行作業(yè),具有更好的兼容性和通用性;
可以切割一些較復雜的晶圓芯片,如六邊形管芯等;
不需要去離子水,不存在刀具磨損問題,并可連續(xù)24小時作業(yè)。

